



TMS-2000 系统以非接触方式测量晶圆平整度,在极端工作环境中抗干扰能力强,可测晶圆尺寸范围上至 12 英寸,其测量精度可达 1nm。
相较于传统晶圆测厚技术的测量精度易受温度变化或环境震动影响,TMS-2000 的创新式硬件设计使其能有效抵抗环境干扰。
TMS-2000 的高速测量能力和一体式紧凑设计使其成为测量各种从轻掺到重掺 P 型硅 (P++),碳化硅,蓝宝石,玻璃,铌酸锂,SOI 等材料晶圆的理想平台。
产品特性
TMS-2000 可实现 1nm 精度的晶圆测厚
• 可应对温度变化和机械震动等环境干扰的高精度测量
• 亚纳米级重复性
• 全晶圆范围的厚度测量,支持客制化扫描模式
• 照明 - 探测一体式光路
• 支持跨样本定量分析和对比
• 可适用于重掺硅、功率半导体、多层结构晶圆等
• 测量结果符合 SEMI 国际标准
• 更高的性价比
测量原理
TMS-2000 的测量原理是基于干涉检测技术,使用高速扫频激光作为光源。
TMS-2000 凭 借 其 高 速、高精度、高灵敏度等特性,广泛应用于晶圆抛光等工艺流程。
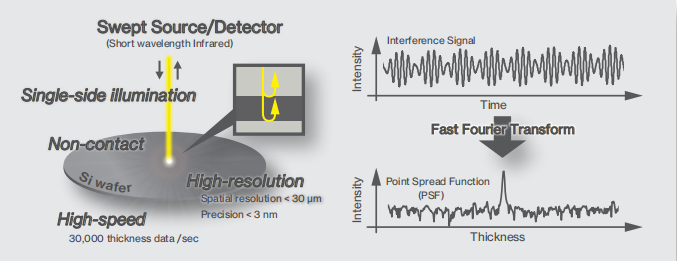
测量方法

应用案例

客制化

规格参数
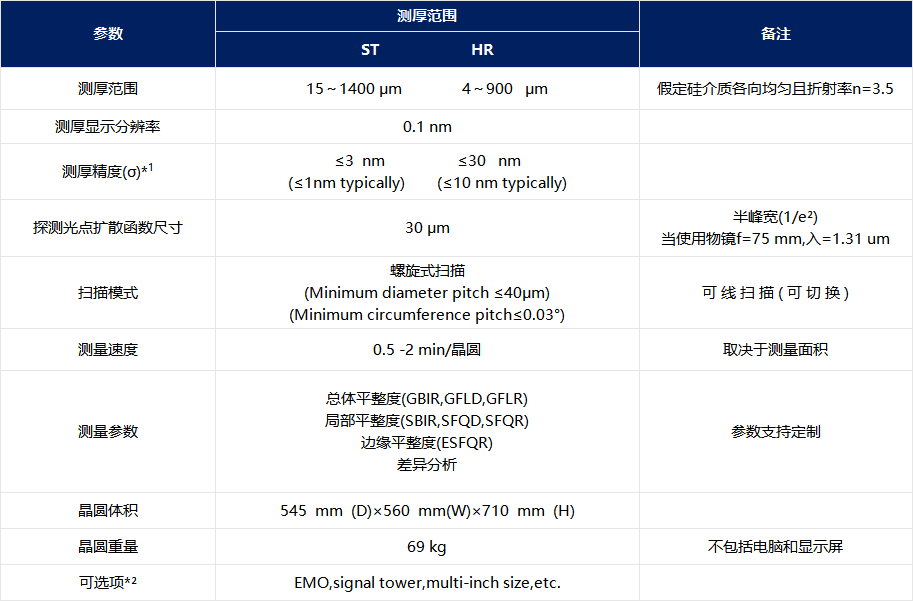
请注意上述规格可能根据实际情况有不同。
上述规格均为室温 23 土 1℃,湿度 80%( 无结霜 ),暖机 1 小时后测得。
*1 该规格为 Santec 标准硅晶圆在同一位置重复 30,000 次测量后所得的标准偏差。
*2 支持定制化,请联系我们。
暂无
如有意向购买产品或者相关技术咨询,请联系我们